来源:立鼎产业研究网
清洗贯穿整个半导体制造。半导体的清洗几乎贯穿整个半导体的流程。从硅片制造时需要对抛光好的硅晶圆进行清洗,去除表面的污染物,到芯片制备中去除光刻胶、湿法刻蚀、CVD 等,再到最后的材料质检。每一个环节都需要清洗以保证下一步不受杂质的干扰,保持产品的良率。同时随着芯片制程的不断缩小,所需要的进行的清洗次数也就越来越多。据统计,清洗工艺的次数占到了在整个芯片制造工艺步骤的三分之一,是芯片制造的重要环节。
DRAM不同节点的清洗次数

LOGIC 不同节点的清洗次数
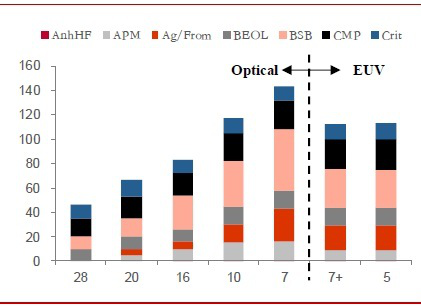
根据ACM 评估,假设一条月产能在10 万片的DRAM 产线,良率下降1%,将会导致企业一年3000-5000 万美元的损失。所以企业为了提高良率,必然会采用更多的清洗次数。
随着制程的缩小,晶圆产量下降

随着制程的缩小,清洗次数也不断提升

半导体工艺不断缩小,单晶圆湿法技术成为主流。在晶圆的前道工艺和后道工艺中,晶圆需要经过无数次的清洗步骤。对于清洗而言,困难在于如何做到提供充足的化学反应或物理力从而去除颗粒污染的同时,尽量少的除去源漏极的硅或隔离槽的SiO2,还不增加表面粗糙度,不损伤已有的门电极。(立鼎产业研究网)关键尺寸的缩小使得清洗的窗口变小,满足清洗效率的同时尽量减少表面和结构的损坏变得不再容易。干法清洗技术以及新的漂洗干燥技术正在研发当中,但是距离应用仍较远。目前在前道工艺中最常见的清洗工艺为单晶圆湿法处理技术。
清洗工艺中湿法与干法技术的占比

半导体中一般的清洗技术
工艺 | 清洁源 | 容器 | 清洁效果 |
剥离光刻胶 | 氧等离子体 | 平板反应器 | 刻蚀胶 |
去聚合物 | 硫酸 | 溶液槽 | 除去有机物 |
去自然氧化层 | 氢氟酸 | 溶液槽 | 产生无氧表面 |
旋转甩干 | 氮气 | 甩干机 | 无任何残留物 |
RCA1(碱性) | 氨水+双氧水 | 溶液槽 | 除去表面颗粒 |
RCA2(酸性) | 盐酸+双氧水 | 溶液槽 | 除去重金属粒子 |
DI清洗 | 去离子水 | 溶液槽 | 除去清洗溶剂 |
单晶圆湿法清洗的步骤为:去分子→去离子→去原子→去离子水冲洗。湿法清洗是指利用各种化学试剂和有机溶剂与吸附在被清洗晶圆表面的杂质及油污发生化学反应或溶解作用,使杂质从被清洗晶圆的表面脱离,然后用大量高纯热、冷去离子水冲洗,从而获得洁净表面的过程。吸附在晶圆表面的杂质可以分为分子型、离子型和原子型三种,分子型杂质较容易清除,离子型和原子型杂质吸附能力较强,所以在清洗时先清除分子型杂质,再清除离子型吸附杂质,然后再清除原子型杂质,用高纯去离子水进行冲洗,最后加热烘干或甩干。